关键词 |
TSV晶圆电镀台,TSV工艺,晶圆电镀机,TSV小型晶圆喷镀台 |
面向地区 |
全国 |
在三维集成中 TSV 技术可分为三种类型:在 CMOS ⼯艺过程之前在硅片 上完成
通孔制作和导电材料填充的是先通孔技术;⽽中通孔,在CMOS制 程之后和后端
制程(BEOL)之前制作通孔。后⼀种后通孔技术是在 CMOS ⼯艺完成后但未
进⾏减薄处理时制作通孔。终技术⽅案的选择要 根据不同的⽣产需求。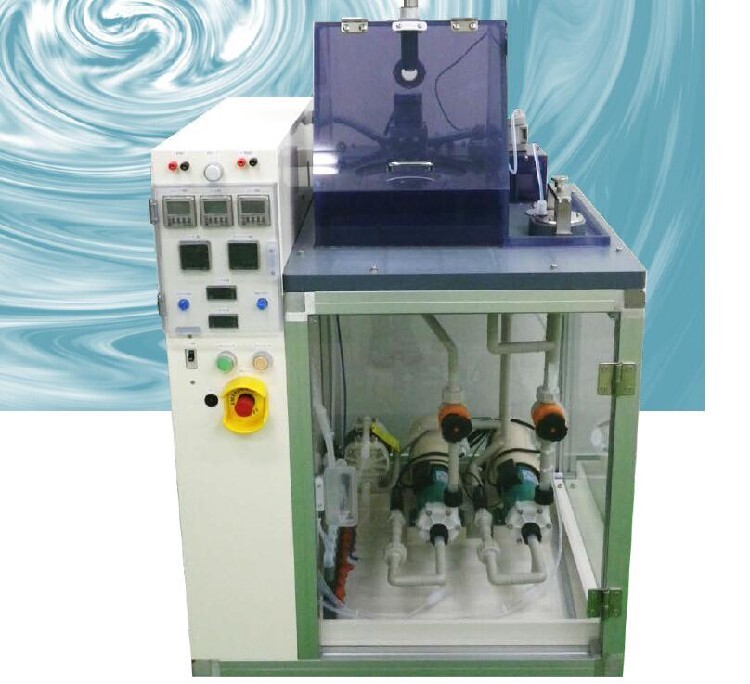
在不同电流密度下的分阶段电沉积实验展示了动态的硅通孔
(TSV) 填充过程。通过控制外加电流密度,可以获得对应于
TSV填充结果的不同形貌。具体来说,低电流密度 (4 mA/
cm 2 ) 会导致接缝缺陷填充,中等电流密度 (7 mA/cm 2 ) 会导
致⽆缺陷填充,⽽⾼电流密度 (10 mA/cm 2 )) 导致空洞缺陷填
充。填充系数分析表明,电流密度对TSV填充模型的影响是
由添加剂和铜离⼦的消耗和扩散的耦合效应触发的。此外,
镀层的形态演变表明局部沉积速率受镀层⼏何特征的影响。
硅通孔 (TSV) 是⼀种很有前途的三维 (3D) 封装技术,具有
⾼性能、减小封装体积、低功耗和多功能等优点。在 TSV ⼯
艺中,通常使用铜电化学沉积 (ECD) 进⾏的通孔填充步骤占
总成本的近 40% 。作为 TSV 的核⼼和关键技术,以小化⼯
艺时间和成本的⽆缺陷填充备受关注。
目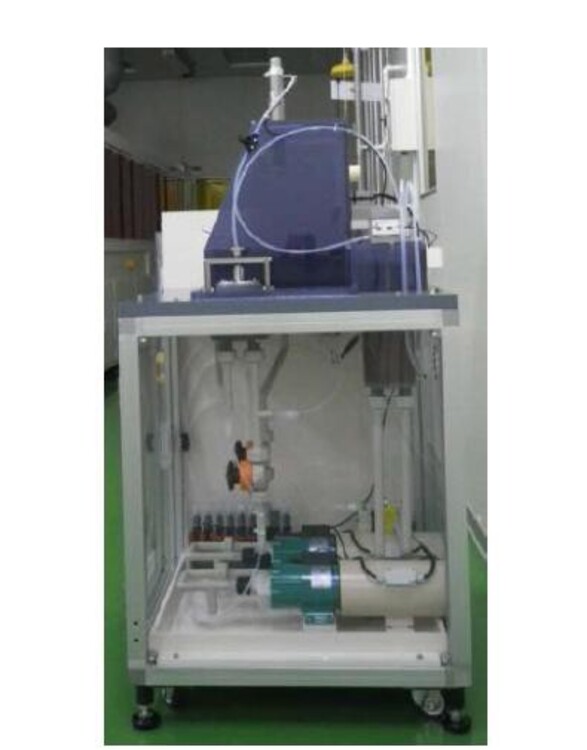
TSV制程关键⼯艺设备
TSV制作⼯艺包括以下⼏步:通孔制作;绝缘层、阻挡层和种⼦层的 沉积;铜填充;
通过化学机械抛光去除多余的⾦属;晶圆减薄;晶圆键合 等。 每⼀步⼯艺都有相
当的技术难度,在通孔制作步骤,保持孔的形状和控制 ⻆度非常重要,通过
Bosch⼯艺来实现深孔刻蚀;在沉积绝缘层、阻挡层 和种⼦层时,需要考虑各层
的均匀性和粘附性;铜填充时避免空洞等 缺陷,这样填充的铜可以在叠层
器件较⾼的温度下保持正常的电性能;⼀ 旦完成了铜填充,则需要对晶圆进⾏
减薄;后是进⾏晶圆键合。
TSV制作流程会涉及到深刻蚀、PVD、CVD、铜填充、微凸点及RDL电 镀、清
洗、减薄、键合等⼆⼗余种设备,其中通孔制作、绝缘层/阻挡层/ 种⼦层的沉
积、铜填充、晶圆减薄、晶圆键合等⼯序涉及的设备为关 键,在某种程度上
直接决定了TSV的性能指标。
电镀铜填充设备
很多成本模型显示,TSV填充⼯艺是整个⼯艺流程中昂贵的步骤之⼀。 TSV
的主要成品率损耗之⼀是未填满的空洞。电镀铜⼯艺作为合适的硅 通孔填充
技术受到业内的普遍关注,其关键技术在于TSV⾼深宽比(通常 ⼤于10:1)通孔的
全填充电镀技术。
封装之TSV及TGV技术初探
其中,玻璃诱导刻蚀法如下:
1) 使用皮秒激光在玻璃上产⽣变性区域;2)将激光处理过的玻璃放在 氢氟酸溶液
中进⾏刻蚀。
| 主营行业:灌封胶水 |
| 公司主营:灌封胶,三防漆,导电胶,导热垫片 |
| 采购产品:灌封胶,导热胶,导电胶,绝缘垫片 |
| 主营地区:北京 |
| 企业类型:有限责任公司(自然人投资或控股) |
| 注册资金:人民币2000000万 |
| 公司成立时间:2016-02-02 |
| 员工人数:小于50 |
| 经营模式:政府或其他机构 |
| 最近年检时间:2016年 |
| 登记机关:朝阳分局 |
| 经营范围:技术开发、技术咨询、技术服务、技术转让,销售社会公共安全设备、电子产品、仪器仪表,橡塑制品、五金交电(不从事实体店铺经营)、金属材料、化工产品(不含危险化学品)、计算机、软件及辅助设备。(企业依法自主选择经营项目,开展经营活动;依法须经批准的项目,经相关部门批准后依批准的内容开展经营活动;不得从事本市产业政策禁止和限制类项目的经营活动。) |
| 公司邮编:100000 |
| 公司电话:010-65747411 |
| 公司网站:www.syource.com |
全国TSV小型晶圆喷镀台热销信息