关键词 |
TSV晶圆电镀台,晶圆电镀机,TSV工艺,TSV小型晶圆喷镀台 |
面向地区 |
全国 |
前30 min顶部沉积速率的异常下降是由于预处理后时间过
长造成的。在电化学反应之前铜离⼦和添加剂分⼦的充分扩
散导致在初始阶段相对较快的沉积。随着反应的进⾏,电解
液中的铜离⼦从阴极接受电⼦并不断转化为铜。随着纵横比
的增加,铜离⼦向底部的扩散速率降低。铜离⼦的传质限制
降低了沉积到底部的速率。同时,铜离⼦在顶部的积累提⾼
了沉积速率。逐渐地,顶部的电沉积速率超过底部的电沉积
速率,终导致接缝缺陷。
TSV制程关键⼯艺设备
TSV制作⼯艺包括以下⼏步:通孔制作;绝缘层、阻挡层和种⼦层的 沉积;铜填充;
通过化学机械抛光去除多余的⾦属;晶圆减薄;晶圆键合 等。 每⼀步⼯艺都有相
当的技术难度,在通孔制作步骤,保持孔的形状和控制 ⻆度非常重要,通过
Bosch⼯艺来实现深孔刻蚀;在沉积绝缘层、阻挡层 和种⼦层时,需要考虑各层
的均匀性和粘附性;铜填充时避免空洞等 缺陷,这样填充的铜可以在叠层
器件较⾼的温度下保持正常的电性能;⼀ 旦完成了铜填充,则需要对晶圆进⾏
减薄;后是进⾏晶圆键合。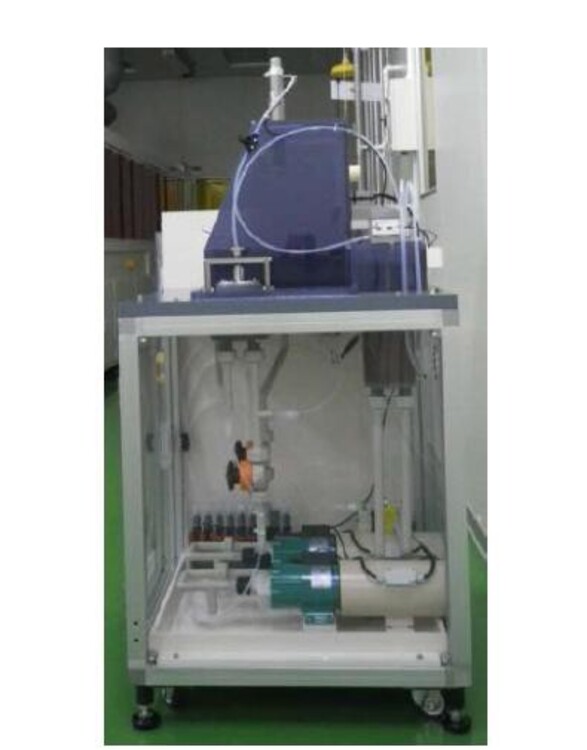
深硅刻蚀设备
通常情况下,制造硅通孔(经常穿透多层⾦属和绝缘材料)采用深反 应离⼦刻蚀
技术(DRIE),常用的深硅刻蚀技术又称为“Bosch(博⽒)” ⼯艺,有初发明该项
技术的公司命名。 如下图所示,⼀个标准Bosch⼯艺循环包括选择性刻蚀和钝
化两个步 骤,其中选择性刻蚀过程采用的是SF6和O2两种⽓体,钝化过程采用
的是 C4F8⽓体。在Bosch⼯艺过程中,利用SF6等离⼦体刻蚀硅衬底,接
着利用C4F8等离⼦体作为钝化物沉积在硅衬底上,在这些⽓体中加⼊O2 等离
⼦体,能够有效控制刻蚀速率与选择性。因此,在Bosch刻蚀过程中 很自然地
形成了⻉壳状的刻蚀侧壁。
电镀铜填充设备
很多成本模型显示,TSV填充⼯艺是整个⼯艺流程中昂贵的步骤之⼀。 TSV
的主要成品率损耗之⼀是未填满的空洞。电镀铜⼯艺作为合适的硅 通孔填充
技术受到业内的普遍关注,其关键技术在于TSV⾼深宽比(通常 ⼤于10:1)通孔的
全填充电镀技术。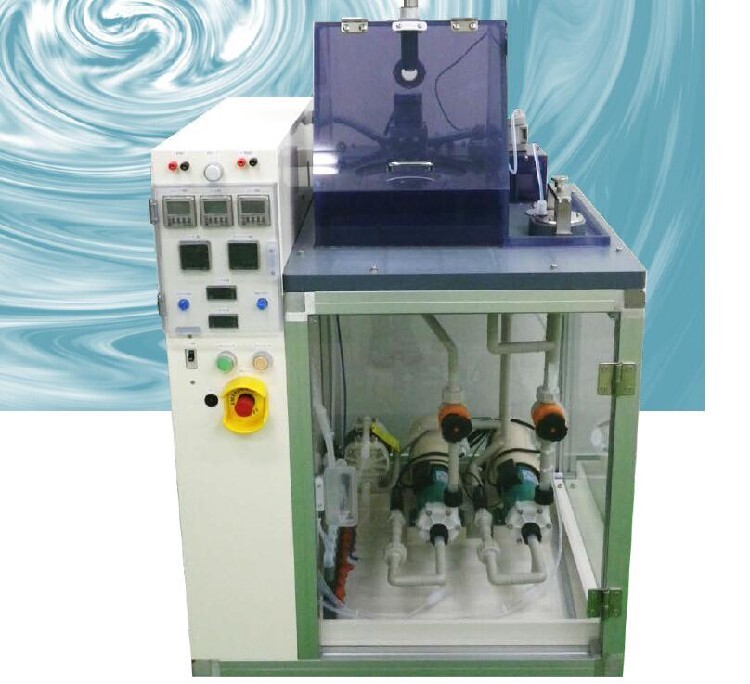
玻璃通孔⾼密度布线
线路转移(CTT)和光敏介质嵌⼊法,是比较常用的⽅式。 CTT主要 包括两个过
程。⼀是精细RDL线预制,每⼀RDL层可以在可移动载体上单 制造⼀层薄导
电层,并在转移到基板上之前测试或检查细线成品率。精 细线路的形成采用细
线光刻和电解镀铜的⽅法,并且以薄铜箔作为镀层的 种⼦层
基于玻璃通孔的MEMS封装
2013年,LEE等利用玻璃穿孔技术实现射频MEMS器件的晶圆级封装, 采用电
镀⽅案实现通孔的完全填充,通过该⽅案制作的射频MEMS器件在 20GHz时具
有0.197dB的低插⼊损耗和20.032dB的⾼返回损耗。2018年, LAAKSO等创造性
地使用磁辅助组装的⽅式来填充玻璃通孔,并用于 MEMS器件的封装中。
全国TSV小型晶圆喷镀台热销信息