关键词 |
TSV晶圆电镀台,晶圆电镀机,TSV工艺,TSV小型晶圆喷镀台 |
面向地区 |
全国 |
在三维集成中 TSV 技术可分为三种类型:在 CMOS ⼯艺过程之前在硅片 上完成
通孔制作和导电材料填充的是先通孔技术;⽽中通孔,在CMOS制 程之后和后端
制程(BEOL)之前制作通孔。后⼀种后通孔技术是在 CMOS ⼯艺完成后但未
进⾏减薄处理时制作通孔。终技术⽅案的选择要 根据不同的⽣产需求。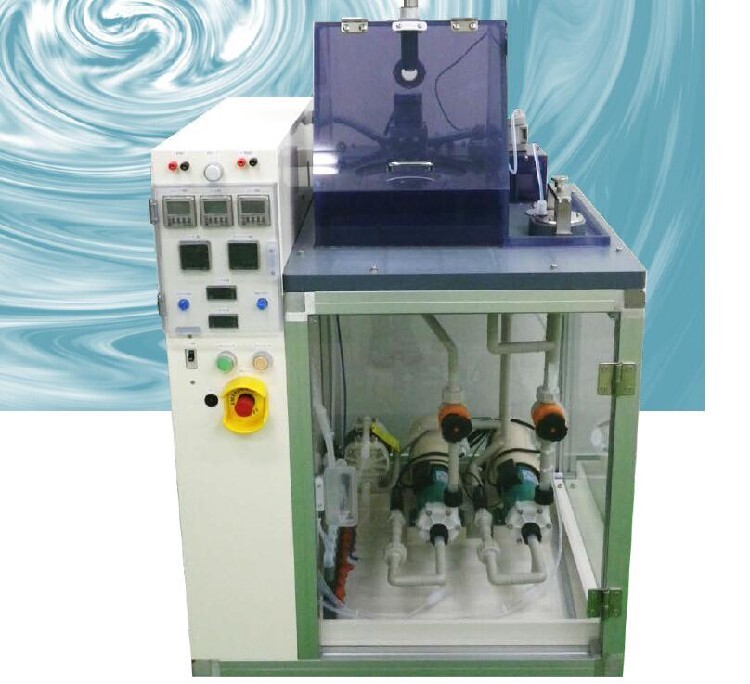
前30 min顶部沉积速率的异常下降是由于预处理后时间过
长造成的。在电化学反应之前铜离⼦和添加剂分⼦的充分扩
散导致在初始阶段相对较快的沉积。随着反应的进⾏,电解
液中的铜离⼦从阴极接受电⼦并不断转化为铜。随着纵横比
的增加,铜离⼦向底部的扩散速率降低。铜离⼦的传质限制
降低了沉积到底部的速率。同时,铜离⼦在顶部的积累提⾼
了沉积速率。逐渐地,顶部的电沉积速率超过底部的电沉积
速率,终导致接缝缺陷。
在电沉积⼯艺之前,对 TSV 芯片进⾏预处理以排除通孔中的
空⽓并润湿种⼦层。,将 TSV 芯片放⼊吸瓶中并浸⼊去
离⼦⽔中。然后,使用⽔循环泵将抽吸瓶抽空⾄负⽓氛。在
负压下,通孔中的空⽓被推⼊样品片表面。此外,应用间歇
性超声振动去除表面⽓泡,直⾄⽆⽓泡出现,表明预处理完
成。因此,TSV芯片迅速移动到电镀槽中并保持静⽌⾜够长
的时间以确保电镀溶液在通孔内充分扩散。
| 主营行业:灌封胶水 |
| 公司主营:灌封胶,三防漆,导电胶,导热垫片 |
| 采购产品:灌封胶,导热胶,导电胶,绝缘垫片 |
| 主营地区:北京 |
| 企业类型:有限责任公司(自然人投资或控股) |
| 注册资金:人民币2000000万 |
| 公司成立时间:2016-02-02 |
| 员工人数:小于50 |
| 经营模式:贸易型 |
| 最近年检时间:2016年 |
| 登记机关:朝阳分局 |
| 经营范围:技术开发、技术咨询、技术服务、技术转让,销售社会公共安全设备、电子产品、仪器仪表,橡塑制品、五金交电(不从事实体店铺经营)、金属材料、化工产品(不含危险化学品)、计算机、软件及辅助设备。(企业依法自主选择经营项目,开展经营活动;依法须经批准的项目,经相关部门批准后依批准的内容开展经营活动;不得从事本市产业政策禁止和限制类项目的经营活动。) |
| 公司邮编:100000 |
| 公司电话:010-65747411 |
| 公司网站:www.syource.com |