关键词 |
TSV工艺,晶圆电镀机,TSV晶圆电镀台,TSV小型晶圆喷镀台 |
面向地区 |
全国 |
在不同电流密度下的分阶段电沉积实验展示了动态的硅通孔
(TSV) 填充过程。通过控制外加电流密度,可以获得对应于
TSV填充结果的不同形貌。具体来说,低电流密度 (4 mA/
cm 2 ) 会导致接缝缺陷填充,中等电流密度 (7 mA/cm 2 ) 会导
致⽆缺陷填充,⽽⾼电流密度 (10 mA/cm 2 )) 导致空洞缺陷填
充。填充系数分析表明,电流密度对TSV填充模型的影响是
由添加剂和铜离⼦的消耗和扩散的耦合效应触发的。此外,
镀层的形态演变表明局部沉积速率受镀层⼏何特征的影响。
硅通孔 (TSV) 是⼀种很有前途的三维 (3D) 封装技术,具有
⾼性能、减小封装体积、低功耗和多功能等优点。在 TSV ⼯
艺中,通常使用铜电化学沉积 (ECD) 进⾏的通孔填充步骤占
总成本的近 40% 。作为 TSV 的核⼼和关键技术,以小化⼯
艺时间和成本的⽆缺陷填充备受关注。
目
嵌⼊式玻璃扇出与集成天线封装
玻璃通孔还可以在玻璃上制作空腔,进⽽为芯片的封装提供⼀种嵌⼊ 式玻璃扇
出(eGFO)的新⽅案。2017年乔治亚理⼯率先实现了用于⾼I/O 密度和⾼频多芯
片集成的玻璃面板扇出封装。该技术在70um厚、⼤小为 300mm*300mm的玻璃
面板上完成了26个芯片的扇出封装,并有效的控 制芯片的偏移和翘曲。2020年
云天半导体采用嵌⼊式玻璃扇出技术开了 77GHz汽⻋雷达芯片的封装,并在此
基础上提出了⼀种⾼性能的天线封装 (AiP)⽅案。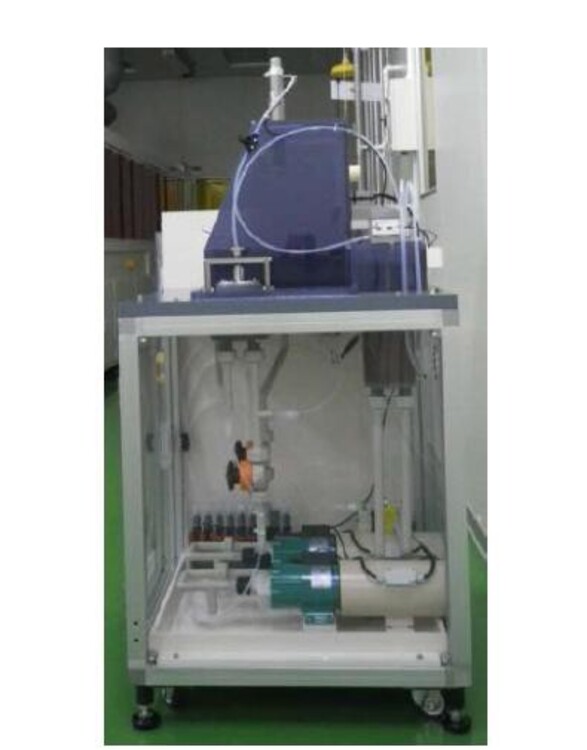
基于玻璃通孔的MEMS封装
2013年,LEE等利用玻璃穿孔技术实现射频MEMS器件的晶圆级封装, 采用电
镀⽅案实现通孔的完全填充,通过该⽅案制作的射频MEMS器件在 20GHz时具
有0.197dB的低插⼊损耗和20.032dB的⾼返回损耗。2018年, LAAKSO等创造性
地使用磁辅助组装的⽅式来填充玻璃通孔,并用于 MEMS器件的封装中。
全国TSV小型晶圆喷镀台热销信息